Este documento describe diferentes tipos de transistores de efecto de campo, incluyendo JFET (transistores de efecto de campo de juntura), MESFET (transistores de efecto de campo de juntura metal-semiconductor), y MOSFET (transistores de efecto de campo de compuerta aislada). Explica el funcionamiento básico de cada tipo de transistor, cómo la tensión de puerta controla la corriente de drenaje-fuente, y las diferentes zonas de operación como la zona resistiva y la zona de saturación. También cubre conceptos como compens

















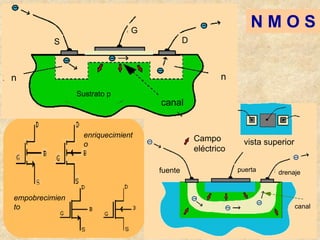
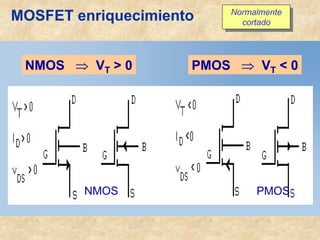

![( ) 2
1
2 -
2
D GS T DS DS
i K v V v v
= −
( ) 2
1
2 -
2
D N ox GS T DS DS
W
i C v V v v
L
µ
= −
vGS > VT
NMOS ⇒ VT > 0
vDS < vGS - VT
zona resistiva u óhmica
iD
vGS
TENSION DRENAJE-FUENTE PEQUEÑAS
vDS
( )
[ ] 1
−
−
=
δ
δ
= T
GS
cte.
V
D
DS
ON V
2K
S
G
r v
i
v
enriquecimiento
( )
2 -
D GS T DS
i K v V v
≅
-
DS GS T
v v V
<<
⇒](https://image.slidesharecdn.com/clase4-fet-231025054946-ce9c3df8/85/Clase-4-FET-pdf-21-320.jpg)

![Si vGS > VT
depende de la geometría
=
L
W
C
µ
K ox
N
depende de la tecnología
si vDS > vGS – VT
( )2
T
S
G
D V
K −
≅ v
i
conducción
( )
[ ]
DS
T
GS
D V
-
K v
v
i 2
=
si vDS < vGS – VT
N
M
O
S](https://image.slidesharecdn.com/clase4-fet-231025054946-ce9c3df8/85/Clase-4-FET-pdf-23-320.jpg)